R&D for Semiconductor
디엔에프는 급변하는 반도체용 화학소재 시장에 적절히 대응하기 위해 다수의 전문인력으로 구성된 연구조직을 운영하고 있으며,
반도체 제조사 및 장비회사와의 공동개발, 독자적 기술 보유 등을 통해 재료의 국산화, 수출증대, 국내외 반도체 산업 발달에 기여하기 위해 노력하고 있습니다.
반도체 재료개발 포트폴리오 (판매 및 개발완료, 개발중)
| Wire |
Alpis-3 |
MABOC (Ep-Cu Seed용) |
CVD/ALD용 Cu Precursor |
| Electrode |
TiCl4 / TEMAT / TDMAT / Ru Precursor |
| High-k |
TEMAHf / TEMAZr |
Zr Precursor |
STO/BST/Zr Precursor |
| Low-k |
|
Low-k (CVD)용 Precursor |
| Gap-Fill |
Polysilazane |
Flowable Oxide용 Precursor |
| Diffusion Barrier |
TiCl4 |
TDMATi / Ta Precursor |
Ru Precursor |
| Etch Hardmask |
SiN |
1-Hexene/Propylene (ACL용) |
SOC용 Precursor |
| Low Temp. Silicon (DPT) |
|
DIPAS |
ALD용 SiO2 |
| New Memory |
Ge / Sb / Te / Fe / Co / Ni Precursor |
| Gate Metal |
(CVD용) Ni / Co / W Precursor |
ALD용 Metal |
| TSV |
ALD용 SiO2 / Ti Precursor / Ta Precursor / CVD용 Cu |
| |
50nm |
40nm |
30nm |
20nm |
10nm~ |
* CVD : Chemical Vapor Deposition 화학기상증착
* ALD : Atomic Layer Deposition 원자층증착
* Ep : Electroplating 전기도금
* SOC : Spin on Carbon
* ACL : Amorphous Carbon Layer 비정질 탄소 박막
* DPT : Double Patterning Technology
* TSV : Through Silicon Via 실리콘 관통 전극
R&D for Display
스마트폰과 태블릿 PC 등의 수요 증가와 Flexible 패널 개발에 따라 디스플레이 소재에 대한 관심이 급증하고 있습니다.
디엔에프는 TFT 기판의 Gate Insulator와 공기 중의 산소 및 수분에 노출되는 것을 방지하기 위해 사용하는 봉지공정(Encapsulation)에 사용할 소재 개발을 진행중입니다.
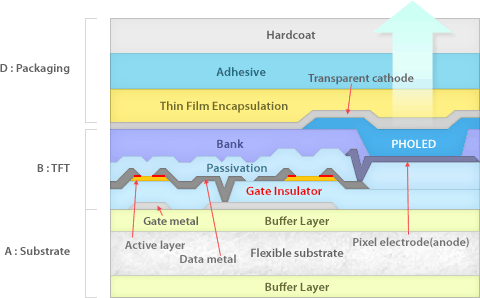
R&D for Nano Tech.
디엔에프는 반도체용 유무기화합물, 디스플레이 소재, 촉매 개발 등의 경험을 바탕으로 다양한 나노소재를 연구하고 있습니다.
지속적인 수요 증가가 예상되는 고기능성 코팅제 및 균일 나노 입자, 귀금속 복합촉매 등의 신규 아이템을 개발하고 있으며,
종합화학소재 전문기업으로 성장하기 위한 기반을 구축하고 있습니다.